Wenn Licht von einer Materialstruktur reflektiert oder durchgelassen wird, kommt es zu einer Änderung der Polarisation. Die Ellipsometrie misst diese Reaktion, die von den optischen Eigenschaften und der Dicke der einzelnen Materialien abhängt. Die Ellipsometrie wird in erster Linie zur Bestimmung der optischen Konstanten und der Schichtdicke verwendet, aber auch zur Charakterisierung der Zusammensetzung, der Kristallinität, der Rauheit, der Dotierungskonzentration und anderer Materialeigenschaften, die mit einer Änderung der optischen Reaktion verbunden sind.
Anwendungsbereiche sind die Grundlagenforschung in den physikalischen Wissenschaften, Halbleiter- und Datenspeicherlösungen, Flachbildschirme, Kommunikation, Biosensoren und die optische Beschichtungsindustrie. Die Ellipsometrie ist außerdem flexibel genug, um die meisten Materialtypen zu messen: Dielektrika, Halbleiter, Metalle, Supraleiter, organische Stoffe, biologische Beschichtungen und Verbundwerkstoffe.
Definition von polarisiertem Licht
Licht kann als eine elektromagnetische Welle beschrieben werden, die sich durch den Raum bewegt. Die Art und Weise, wie sich das Feld einer elektromagnetischen Welle in Bezug auf Raum und Zeit verhält, wird als Polarisation bezeichnet. Licht gilt als unpolarisiert, wenn seine Ausrichtung und Phase völlig willkürlich sind. Die Ellipsometrie hingegen misst polarisiertes Licht – ein elektrisches Feld, das einem bestimmten Weg folgt und an jedem beliebigen Punkt eine bestimmte Form aufweist. Eine elektromagnetische Welle, die sich in z-Richtung ausbreitet, kann durch ihre x- und y-Komponenten beschrieben werden, da ihr elektrisches Feld immer orthogonal zur Ausbreitungsrichtung ist. Wenn zwei orthogonale Lichtwellen in Phase sind, ist das resultierende Licht linear polarisiert. Seine Ausrichtung wird durch die relativen Amplituden bestimmt. Das Licht gilt als zirkular polarisiert, wenn die orthogonalen Wellen um 90° phasenverschoben sind und die gleiche Amplitude haben. Die häufigste Polarisation ist elliptisch und kombiniert orthogonale Wellen beliebiger Amplitude und Phase. Daher hat die Ellipsometrie ihren Namen.
Unterschiedliche Arten der Polarisation:
Linear

Zirkular
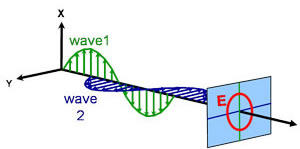
Elliptisch
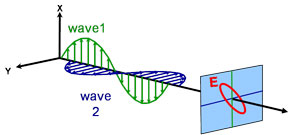
Optische Eigenschaften
Die optischen Eigenschaften, die bestimmen, wie Licht mit einem Material wechselwirkt, werden durch zwei Werte beschrieben. Sie werden im Allgemeinen als komplexe Zahl dargestellt. Der komplexe Brechungsindex (ñ) besteht aus dem Index (n) und einem Extinktionskoeffizienten (k):
![]()
Die optischen Eigenschaften können auch als komplexe dielektrische Funktion dargestellt werden:
![]()
mit der folgenden Beziehung zwischen den Konventionen:
![]()
Der Index stellt die Phasengeschwindigkeit des Lichts beim Durchgang durch ein Material im Vergleich zur Lichtgeschwindigkeit im Vakuum, c, dar:

Wenn das Licht in ein Material mit einem höheren Index eintritt, wird es langsamer. Da sich die Frequenz der Lichtwellen nicht ändert, verkürzt sich die Wellenlänge. Der Verlust von Wellenenergie an das Material wird durch den Extinktionskoeffizienten beschrieben, der mit dem Absorptionskoeffizienten wie folgt zusammenhängt:

Nach dem Beerschen Gesetz verliert das Licht in einem absorbierenden Material an Intensität. Der Extinktionskoeffizient gibt an, wie schnell das Licht in einem Material verschwindet.
![]()
Abbildung 4 zeigt eine Lichtwelle, die zwei verschiedene Materialien mit unterschiedlichen Eigenschaften durchläuft, bevor sie in die Umgebung zurückkehrt.

Abbildung 4: Lichtwelle, die von der Luft in den absorbierenden Film 1 und dann in den transparenten Film 2 läuft. Phasengeschwindigkeit und Wellenlänge ändern sich in beiden Materialien in Abhängigkeit vom Brechungsindex (Film 1: n=4, Film 2: n=2).
Die Wellenlänge bestimmt die optischen Konstanten. Abbildung 5 zeigt die optischen Konstanten für TiO2 von UV bis IR. Aufgrund unterschiedlicher Prozesse, die der Lichtwelle Energie entziehen, kommt es sowohl im UV als auch im IR zur Absorption (k>0). Die IR-Absorption wird in der Regel durch Molekular- oder Phononenschwingungen oder freie Träger verursacht. Die UV-Absorption wird im Allgemeinen durch elektronische Übergänge verursacht, bei denen die Lichtenergie Elektronen zu höheren Zuständen anregt. Abbildung 5 zeigt, dass hypothetische oder reale optische Konstanten nicht unabhängig sind, sondern durch Kramers-Kronig-Beziehungen mathematisch miteinander verknüpft sind.
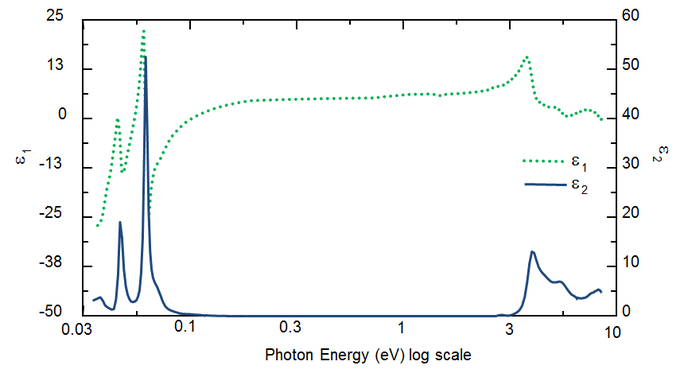
Abbildung 5: Komplexe dielektrische Funktion für TiO2-Film mit Wellenlängen von IR (kleine eV) bis UV (hohe eV).
Wechselwirkung von Licht und Materialien
Wenn Licht mit einem Material wechselwirkt, führt dies zu Randbedingungen an der Grenzfläche. Dabei müssen die Maxwellschen Gleichungen immer erfüllt bleiben. Die folgende Abbildung zeigt, wie einfallendes Licht an der Grenzfläche reflektiert und gebrochen wird. Der Winkel zwischen dem einfallenden Strahl und der Probennormalen (θi) ist gleich dem reflektierten Winkel (θr). Licht, das in ein Material eintritt, wird unter einem Winkel θt gebrochen, der durch folgende Gleichung gegeben ist:
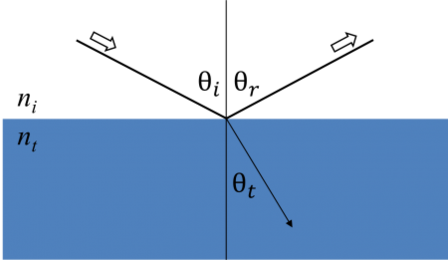
Abbildung 6: Licht reflektiert und bricht sich nach dem Snellschen Gesetz.
An jeder Grenzfläche wird ein Teil des Lichts reflektiert, während der Rest unter dem Brechungswinkel durchgelassen wird. Je nach Randbedingungen gelten unterschiedliche Lösungen für elektrische Felder parallel und senkrecht zur Probenoberfläche. Das Licht lässt sich also in orthogonale Komponenten in Bezug auf die Einfallsebene aufteilen (p- und s-polarisiert). Beide Komponenten können getrennt berechnet werden. So beschrieb Fresnel die Lichtmenge, die an einer Grenzfläche zwischen Materialien reflektiert und transmittiert wird:




Mehrere Grenzflächen mit eigenen Fresnel-Reflexions- und Transmissionskoeffizienten treten bei Dünnschicht- und Mehrschichtstrukturen auf. Um den reflektierten oder transmittierten Strahl korrekt zu definieren, muss die relative Phase jeder Lichtkomponente verfolgt werden. Die Schichtphasendicke wird also wie folgt bestimmt:

Wenn sich mehrere Lichtwellen überlagern, kommt es zu Interferenzen, die von der relativen Phase jeder einzelnen Lichtwelle abhängen. Die folgende Abbildung zeigt die Kombination von Lichtwellen im reflektierten Strahl und die entsprechenden Fresnel-Berechnungen.
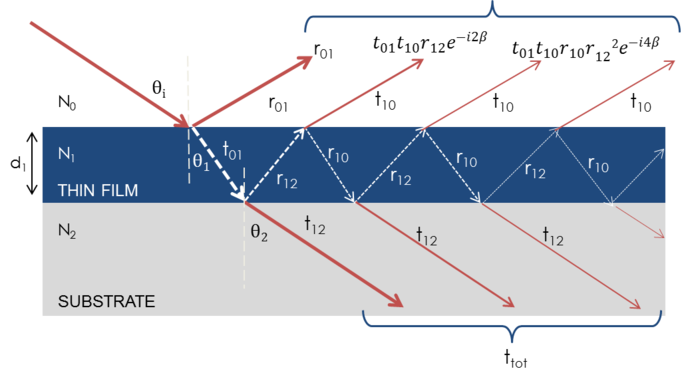
Abbildung 7: Licht wird an jeder einzelnen Grenzfläche reflektiert und gebrochen, was zu mehreren Strahlen in einer dünnen Schicht führt. Die Interferenz der Strahlen hängt von der relativen Phase und Amplitude der elektrischen Felder ab. Die Strahlenreaktion kann mit Fresnel-Reflexions- und Transmissionskoeffizienten berechnet werden.
Messungen
Die Ellipsometrie misst hauptsächlich, wie p- und s-Komponenten bei der Reflexion oder Transmission zueinander reagieren. Ein Referenzstrahl ist also immer Teil des Experiments. Eine bekannte Polarisation wird von der Probe reflektiert oder durchgelassen, und die Ausgangspolarisation wird gemessen. Die Polarisationsänderung ist die ellipsometrische Messung:
![]()
Abbildung 6 zeigt eine typische ellipsometrische Probenmessung. Das linear einfallende Licht hat sowohl p- als auch s- Komponenten. Das reflektierte Licht zeigt sowohl Amplituden- als auch Phasenänderungen für p- und s- polarisiertes Licht. Diese Änderungen werden durch Ellipsometrie gemessen.

Um Ellipsometriedaten zu erfassen, werden benötigt: Lichtquelle, Polarisationsgenerator, Probe, Polarisationsanalysator und Detektor. Sowohl der Polarisationsgenerator als auch der Analysator bestehen aus optischen Teilen, die die Polarisation beeinflussen: Kompensatoren, Polarisatoren und Phasenmodulatoren. Typische Ellipsometer-Konfigurationen umfassen einen rotierenden Analysator (RAE), einen rotierenden Polarisator (RPE), einen rotierenden Kompensator (RCE) und eine Phasenmodulation (PME). Die folgende Abbildung zeigt eine RAE-Konfiguration.

Unpolarisiertes Licht wird von einer Lichtquelle erzeugt und dann durch einen Polarisator geschickt. Der Polarisator ist so eingestellt, dass nur Licht mit einer bestimmten elektrischen Feldorientierung durchgelassen wird. Da die Achse des Polarisators zwischen der p- und s-Ebene ausgerichtet ist, erreichen beide die Probenoberfläche. Das nun linear polarisierte Licht wird von der Probenoberfläche reflektiert, wodurch es elliptisch polarisiert wird, und dann durch einen kontinuierlich rotierenden Polarisator (den „Analysator“) geschickt. Die Lichtmenge, die durchgelassen wird, hängt von der Ausrichtung des Polarisators in Bezug auf die Ellipse des elektrischen Feldes der Probe ab. Um die reflektierte Polarisation zu bestimmen, wird das Licht im Detektor in ein elektronisches Signal umgewandelt. Der Vergleich dieser Daten mit der ermittelten Eingangspolarisation gibt Aufschluss über die durch die Probenreflexion verursachte Änderung: die ellipsometrische Messung von Psi und Delta.
Datenanalyse
Die Ellipsometrie wird zur Bestimmung der Materialschichtdicke oder optischer Konstanten durch Messung der Änderungen der Lichtpolarisation verwendet. „Pseudo“-Optikkonstanten aus der Ellipsometriemessung können durch Umkehrung der für eine einzelne Reflexion ermittelten Daten abgeleitet werden. Dies ist für Massenmaterial nützlich.

Die obige Gleichung gilt nicht für Oberflächenschichten. Dennoch gibt es in der Regel ein Oberflächenoxid oder eine Rauheit in Bulk-Materialien. Bei einer direkten Inversion werden diese Daten als Teil der optischen Konstanten des Materials berücksichtigt. Abb. 10 gibt einen Überblick über ein typisches Datenanalyseverfahren, das bei ellipsometrischen Messungen verwendet wird. Da eine exakte Gleichung nicht geschrieben werden kann, ist eine Regressionsanalyse erforderlich. Mit nur wenigen Unbekannten und Hunderten von experimentellen Datenpunkten ist die Antwort oft überbestimmt. Eine Regressionsanalyse ermöglicht es, alle gemessenen Daten in die Bestimmung der Lösung einzubeziehen.

Abbildung 10: Flussdiagramm für die Datenanalyse der Ellipsometrie.
Die Datenanalyse erfolgt nach folgendem Verfahren: Die Probe wird gemessen und ein Modell der Probe erstellt. Mit Hilfe dieses Modells werden die angenommenen Ergebnisse aus den Fresnelschen Gleichungen, die die Dicke und die optischen Konstanten der einzelnen Materialien beschreiben, berechnet. Wenn diese Werte nicht bekannt sind, wird eine Bewertung der vorläufigen Berechnung vorgenommen. Die berechneten Werte werden mit experimentellen Daten verglichen. Um eine bessere Übereinstimmung zwischen den experimentellen und den berechneten Daten zu erreichen, können die unbekannten Materialdaten variiert werden. Die Anzahl der experimentellen Datenpunkte sollte jedoch immer größer sein als die der unbekannten Parameter. So können beispielsweise mit einem Ein-Wellenlängen-Ellipsometer maximal zwei Materialeigenschaften bestimmt werden, da es genau zwei Datenpunkte liefert: Ψ, Δ (Psi und Delta). Mit Hilfe der Regression wird die beste Übereinstimmung zwischen Modell und Experiment ermittelt. Der Unterschied zwischen den Datenkurven wird mit Hilfe eines Schätzers wie dem mittleren quadratischen Fehler (MSE) quantifiziert. Unbekannte Eigenschaften werden variiert, bis der minimale MSE erreicht ist. Das bedeutet, dass der niedrigste MSE-Wert der besten Antwort entspricht.
Die folgende Abbildung zeigt die MSE-Kurve in Abhängigkeit von der Schichtdicke für eine transparente Schicht auf Silizium. Der niedrigste MSE-Wert tritt bei einer Schichtdicke von 749 nm auf, trotz einer Reihe von lokalen Minima. Die korrekte Schichtdicke beträgt also ebenfalls 749 nm. Der Regressionsalgorithmus könnte ein lokales Minimum als korrekt ansehen. Um das korrekte globale Minimum zu bestimmen, ist es daher ratsam, die Ergebnisse mit dem Auge für das niedrigste MSE zu vergleichen.

Abbildung 11, oben rechts: Experimentelle Daten und entsprechende Kurven, die für das Modell am globalen Minimum erzeugt wurden. Abbildung 11, oben links: Eine ähnliche Kurve am lokalen Minimum bei einer Dicke von 0,45 µm kann leicht als falsches Ergebnis identifiziert werden. Abbildung 11, unten: Die MSE-Kurve gegen die Dicke zeigt das globale Minimum. Ein Regressionsalgorithmus kann lokale Minima liefern, aber nicht das endgültige Ergebnis.
Bestimmung der Schichtdicke
Die Schichtdicke wird in der Regel durch die Interferenz zwischen dem Licht, das von der Oberfläche reflektiert wird, und dem Licht, das durch die Schicht dringt, bestimmt. Ob diese Interferenz als konstruktiv oder destruktiv angesehen wird, hängt von der relativen Phase des Lichts ab, das mit der Oberflächenreflexion zusammenfällt. Die Interferenz enthält sowohl Amplituden- als auch Phaseninformationen. Die Δ-Phaseninformation ist sehr empfindlich für Schichten bis hinunter zur Sub-Monolayer-Dicke. Die folgende Abbildung zeigt einen Vergleich der reflektierten Intensität und der Ellipsometrie für dieselbe Serie dünner SiO2-Schichten auf Si. Der Reflexionsgrad ist für jede Schicht nahezu gleich, während es große Unterschiede bei Δ.

Abbildung 12, links: Reflektierte Intensität und ellipsometrisches Delta (rechts) für zwei dünne Oxide auf Silizium. Die Intensitätsmessung zeigt nicht, dass Delta sehr empfindlich für Schichten im Nanometerbereich ist.
Ellipsometrie wird üblicherweise für Schichten von Sub-Nanometern bis zu einigen Mikrometern Dicke verwendet. Bei Filmen, die dicker als einige zehn Mikrometer sind, können Interferenzschwingungen nur mit zunehmender Schwierigkeit aufgelöst werden, es sei denn, es werden längere Infrarot-Wellenlängen verwendet. Deshalb werden für dickere Schichten normalerweise andere Messverfahren verwendet.
Um die Dicke zu messen, muss ein Teil des Lichts die gesamte Schicht durchqueren und dann zur Oberfläche zurückkehren. Bei lichtabsorbierenden Materialien können optische Dickenmessungen nur an dünnen und halb undurchsichtigen Schichten durchgeführt werden, es sei denn, sie werden in Spektralbereichen mit geringerer Absorption durchgeführt. So kann beispielsweise ein organischer Film, der UV- und IR-Licht absorbiert, im mittleren sichtbaren Wellenlängenbereich transparent sein. Metalle absorbieren stark bei allen Wellenlängen, so dass die maximale Schichtdicke, die bestimmt werden kann, bei etwa 100 nm liegt.
Optische Konstanten
Optische Konstanten spielen bei Dickenmessungen eine wichtige Rolle. Die Dicke einer Folie beeinflusst die Weglänge des Lichts, das sich durch die Folie bewegt, der Index bestimmt die Geschwindigkeit und den Brechungswinkel der Lichtwelle. Beide tragen also zur Verzögerung zwischen dem Licht, das die Folie durchläuft, und der Oberflächenreflexion bei. Es ist notwendig, n und k sowie die Dicke zu bestimmen, um korrekte Ergebnisse aus einer optischen Messung zu erhalten.
Da die optischen Konstanten eines Materials für verschiedene Wellenlängen variieren, müssen alle Wellenlängen, die mit dem Ellipsometer analysiert werden, einzeln bestimmt werden. Die Reaktion eines Materials bei jeder Wellenlänge kann mit Hilfe einer Tabelle der optischen Konstanten vorhergesagt werden. Um die mühsame Anpassung unbekannter optischer Konstanten für jede einzelne Wellenlänge zu vermeiden, ist es vorteilhaft, alle Wellenlängen gleichzeitig zu verwenden. Die einstellbaren Parameter einer Dispersionsrelation ermöglichen es beispielsweise, die Gesamtform der optischen Konstanten an die experimentellen Ergebnisse anzupassen. Verglichen mit der Einstellung einzelner n- und k-Werte für jede Wellenlänge wird die Anzahl der unbekannten freien Parameter erheblich reduziert.
Cauchy- oder Sellmeier-Beziehungen werden häufig zur Beschreibung des Index für transparente Materialien verwendet, wobei die Cauchy-Beziehung normalerweise wie folgt angegeben wird:

mit den drei Termen, die so angepasst werden, dass sie dem Brechungsindex des Materials entsprechen. Die Cauchy-Beziehung ist nicht durch die Kramers-Kronig (KK)-Konsistenz begrenzt und kann zu unphysikalischer Dispersion führen. Die Sellmeier-Relation erzwingt dagegen die Kramers-Kronig (KK)-Konsistenz, die sicherstellt, dass die optische Dispersion eine realistische Form behält. Die Sellmeier-Relation wird üblicherweise wie folgt geschrieben:

Absorbierende Materialien haben oft einen transparenten Wellenlängenbereich, der mit der Cauchy- oder Sellmeier-Relation modelliert werden kann. Für den absorbierenden Bereich müssen jedoch sowohl reale als auch imaginäre optische Konstanten berücksichtigt werden. Um die Absorption für verschiedene Materialien zu beschreiben, verwenden viele Dispersionsbeziehungen die Oszillatortheorie, darunter Lorentz, Harmonic und Gauss. Alle haben ähnliche Eigenschaften, wobei die Absorptionsmerkmale mit Amplitude, Verbreiterung und Zentrumsenergie (bezogen auf die Frequenz des Lichts) beschrieben werden. Die Form der realen Komponente wird mithilfe der Kramers-Kronig-Konsistenz berechnet, nachdem das imaginäre Verhalten durch den Oszillator beschrieben wurde. Um mögliche zusätzliche Absorption außerhalb des gemessenen Spektralbereichs zu berücksichtigen, wird ein Offset zur realen Komponente hinzugefügt. Der Lorentz-Oszillator lässt sich wie folgt beschreiben:
![]()
Abbildung 13 zeigt auch Amplitude (A), Verbreiterung (B), Mittenenergie (Ec) und Offset (e1, off set) für einen typischen Lorentz-Oszillator. Die Energie E ist mit der Frequenz einer Welle, n, verknüpft:

Die Plancksche Konstante h und die Wellenlänge λ sind in Nanometern angegeben. Andere Dispersionsmodelle wie Tauc-Lorentz und Cody-Lorentz enthalten Begriffe zur Beschreibung der Bandlückenenergie.

Further Reading
Ellipsometrie ist ein etabliertes optisches Verfahren zur Messung von dünnen Schichten und Massenmaterialien. Sie nutzt die Polarisationsänderungen, die durch Reflexion/Transmission an einer Materialstruktur verursacht werden, um die Materialeigenschaften wie Dicke und optische Konstanten zu bestimmen.
Aspnes D.E. (1985). Die genaue Bestimmung von optischen Eigenschaften durch Ellipsometrie. In: Palik E.D. (ed.) Handbook of Optical Constants of Solids, pp. 89-112. Academic Press, Orlando.
Azzam R.M.A. und Bashara N.M. (1987). Ellipsometry and Polarized Light, Elsevier Science B.V., Amsterdam, The Netherlands.
Boccara A.C., Pickering C., and Rivory J. (eds.), (1993). Spectroscopic Ellipsometry, Elsevier Publishing, Amsterdam.
Collins R.W., Aspnes D.E., and Irene E.A. (eds.), (1998). „Proceedings from the Second International Conference on Spectroscopic ellipsometry“. In: Thin Solid Films, vols. 313-314.
Fujiwara H., Spectroscopic Ellipsometry, Principles and Applications, John Wiley & Sons, Ltd. 2007
Gottesfeld S., Kim Y.T., and Redondo A. (1995). „Recent applications of ellipsometry and spectroellipsometry in electrochemical systems“, In: I. Rubinstein (ed.), Physical Electrochemistry: Principles, Methods, and Applications, Marcel Dekker, New York.
Herman, I.P. (1996). Optical Diagnostics for Thin Film Processing, S. 425-479. Academic Press, San Diego, California.
Johs B. et al (1999). „Overview of Variable Angle Spectroscopic Ellipsometry (VASE), Part II: Advanced Applications“. Optical Metrology, vol. CR72, pp 29-58. SPIE, Bellingham, Washington.
Johs B. et al (2001). „Recent Developments in Spectroscopic Ellipsometry for in situ Applications“. In: Duparré A, Singh B (ed.) Optical Metrology Roadmap for the Semiconductor, Optical, and Data Storage Industries II, vol. 4449, pp 41-57. SPIE, Bellingham, Washington.
Roseler A. (1990). Infrarotspektroskopische Ellipsometrie, Akademie-Verlag, Berlin.
Rossow U. und Richter W. (1996). „Spektroskopische Ellipsometrie“ in: Bauer G und Richter W (eds.) Optical Characterization of Epitaxial Semiconductor Layers, pp. 68-128, Springer-Verlag, Berlin.
Tompkins H.G. (1993). A User’s Guide to Ellipsometry, Academic Press, San Diego, California.
Tompkins H.G. und McGahan W.A. (1999). Spectroscopic Ellipsometry and Reflectometry, John Wiley & Sons, Inc., USA.
Tompkins, H.G. und Irene E.A. (eds.), 2005, Handbook of Ellipsometry, William Andrew Publishing, New York.
Tompkins, H. G. und Hilfiker, J. H., Spectroscopic Ellipsometry, Practical Application to Thin Film Characterization, 2016, Momentum Press Engineering
Woollam J.A. und Snyder P.G. (1992). „Variable Angle Spectroscopic Ellipsometry“ in: Brundle CR, Evans CA, and Wilson S (eds) Encyclopedia of Materials Characterization: Surfaces, Interfaces, Thin Films, pp. 401-411, Butterworth-Heinemann, Boston.
Woollam J.A. et al (1999). „Overview of Variable Angle Spectroscopic Ellipsometry (VASE), Part I: Basic Theory and Typical Applications“. Optische Metrologie, Bd. CR72, S. 3-28. SPIE, Bellingham, Washington.
Woollam J.A. (2000). „Ellipsometry, Variable Angle Spectroscopic“ in: Webster J.G. (ed.) Wiley Encyclopedia of Electrical and Electronics Engineering, pp. 109-116. John Wiley & Sons, New York.